Laser-Schneid- und Graviertechnologien
Verdampfungsschneiden #
Beim Verdampfungsschneiden erhitzt der fokussierte Strahl die Oberfläche des Materials bis zum Siedepunkt und erzeugt eine Schlüssellochbildung.
Das Schlüsselloch führt zu einem plötzlichen Anstieg der Absorptionsfähigkeit, wodurch das Loch schnell vertieft wird.
Mit der Vertiefung des Lochs und dem Sieden des Materials erodiert der erzeugte Dampf die geschmolzenen Wände, bläst Ejecta heraus und vergrößert das Loch weiter.
Nichtschmelzendes Material wie Holz, Kohlenstoff und Duroplastik werden normalerweise mit dieser Methode geschnitten.

Schmelzen und Blasen #
Beim Schmelzen und Blasen oder Fusionschneiden wird hochdruckgas verwendet, um geschmolzenes Material aus dem Schneidbereich zu blasen, wodurch der Energiebedarf erheblich verringert wird.
Zuerst wird das Material bis zum Schmelzpunkt erhitzt, dann bläst ein Gasstrahl das geschmolzene Material aus dem Kerf, wodurch die Notwendigkeit entfällt, die Temperatur des Materials weiter zu erhöhen.
Materialien, die mit diesem Verfahren geschnitten werden, sind normalerweise Metalle.
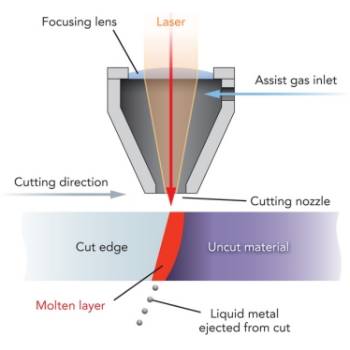
Thermische Spannungsspaltung #
Der Vollkörperbruch bildet sich an der Stelle, an der der Spannungsintensitätsfaktor den maximalen Wert annimmt.
Diese Position fällt normalerweise nicht mit der Stelle zusammen, an der die Temperatur maximal wird, was den sogenannten Größeneffekt erzeugt.
Dieser Größeneffekt wird vermieden, indem die Richtung der Arbeitsverzerrung, die mit dem Vollkörperbruch einhergeht, senkrecht zur Arbeitsfläche umgewandelt wird.
Der Fall der Oberflächengravur ist viel einfacher, erfordert jedoch eine Kühlungseinheit unmittelbar nach dem Ende der Arbeitserwärmung.
Da der gegenwärtige Geschäftswettbewerb größtenteils mit der Technologie der Oberflächengravur durchgeführt wird, wird der Wettbewerb größtenteils darauf abzielen, die Fähigkeit der Technologie der Oberflächengravur zu verbessern.
http://www.industrial-lasers.com/articles/2011/11/thermal-stress-cleavage-is-a-new-business.html
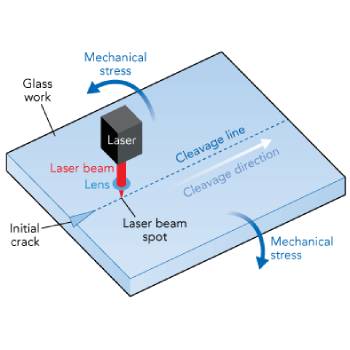
Stealth-Dicing von Silizium #
Die Trennung von mikroelektronischen Chips, die in der Halbleitergeräteherstellung von Siliziumwafern vorbereitet sind, kann durch den sogenannten Stealth-Dicing-Prozess erfolgen, der mit einem gepulsten Nd:YAG-Laser arbeitet, dessen Wellenlänge gut an die elektronische Bandlücke von Silizium angepasst ist.
![]()
Reaktives Laserschneiden #
Auch bekannt als "verbrennungsstabilisiertes Laser-Gasschneiden", "Flammenschneiden". Das reaktive Schneiden ist ähnlich wie das Sauerstoffbrennschneiden, jedoch mit einem Laserstrahl als Zündquelle. Wird hauptsächlich zum Schneiden von Kohlenstoffstahl in Dicken über 1 mm verwendet.
Dieses Verfahren kann verwendet werden, um sehr dicke Stahlplatten mit relativ geringer Laserleistung zu schneiden.
